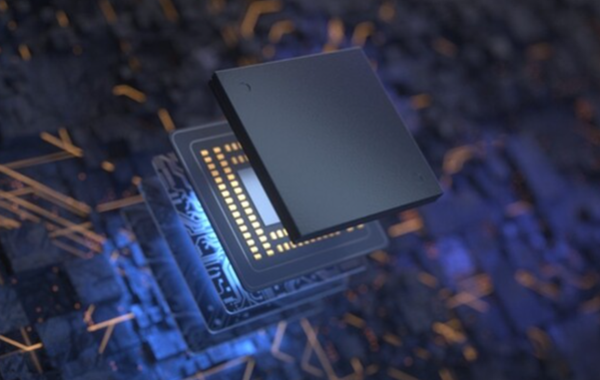 ▲ 첨단패키징(출처:테크인사이츠)
▲ 첨단패키징(출처:테크인사이츠)AI(인공지능)와 HPC(고성능 컴퓨팅) 수요가 폭발적으로 증가하면서, 반도체 첨단 패키징 기술이 내년부터 본격 상용화 단계에 진입할 전망이다. 특히 CPO(Co-Packaged Optics)와 차세대 HBM4 등 혁신 기술이 시장 성장을 이끌며 글로벌 반도체 산업의 경쟁 구도를 재편할 것으로 보인다.
반도체 산업 분석기관 테크인사이츠(TechInsights)는 최근 발표한 ‘2026 반도체 첨단 패키징 전망 보고서’에서 첨단 패키징 기술이 글로벌 반도체 시장의 핵심 성장 동력으로 자리 잡고 있다고 23일 밝혔다.
보고서는 AI와 HPC 시장의 확대로 고성능 반도체 수요가 급증하면서, 기존 실리콘 기반 집적 기술의 한계를 보완할 새로운 패키징 기술의 필요성이 커지고 있다고 분석했다.
특히 CPO(Co-Packaged Optics, 공동 광학 패키징), 차세대 HBM4, 유리 기판, 패널 레벨 패키징, 첨단 열 관리 솔루션 등을 2026년 시장 성장을 주도할 핵심 기술로 꼽았다.
CPO는 광 송수신 모듈을 칩 근처 또는 패키지 내부에 직접 통합하는 기술로, 기존의 착탈식 트랜시버 방식보다 전력 효율을 크게 개선할 수 있다. 데이터 이동량이 폭증하는 AI 서버와 데이터센터에서는 전력 소모와 발열이 주요 과제로 떠올랐는데, CPO는 이러한 문제를 획기적으로 줄일 수 있는 대안으로 평가된다.
테크인사이츠는 현재 TSMC, 엔비디아, 브로드컴 등 글로벌 주요 기업들이 관련 제품 출시를 준비하고 있다며, 내년이 CPO 기술 상용화의 전환점이 될 것이라고 내다봤다. 기술 발전 로드맵 또한 플러그형 트랜시버에서 온보드 옵틱스, CPO 엣지, 칩 간 광통신으로 이어지는 점진적 진화가 예상된다.
HBM4 역시 첨단 패키징 시장을 이끄는 또 다른 핵심 기술로 꼽혔다. HBM4는 기존 제품보다 적층 높이와 데이터 처리 속도가 대폭 향상된 3D 패키징 솔루션이다. 하지만 스택 구조가 복잡해질수록 수율 관리와 열 제어가 핵심 과제로 떠오르고 있다.
또한 고성능 반도체의 대형화와 함께 유리 기판과 패널 레벨 패키징으로의 전환이 빠르게 진행되고 있다. 유리 기판은 실리콘 대비 열 안정성과 배선 특성이 우수해 대면적 설계에 적합하며, 패널 레벨 패키징은 생산 단위를 넓혀 공정 효율을 높이고 비용을 절감할 수 있다는 장점이 있다. 이에 맞춰 주요 반도체 기업들은 첨단 패키징 설비 투자와 공급망 재편을 가속화하고 있다.
3D 적층 기술 확산으로 인한 발열 문제 역시 업계의 주요 과제로 부상했다. 이에 따라 데이터센터를 중심으로 액침 냉각(liquid cooling), 고성능 열 인터페이스 소재(TIM), 백사이드 파워 딜리버리(backside power delivery) 등의 첨단 열 관리 솔루션 도입이 확대되고 있으며, 이 기술들은 향후 모바일과 가전제품에도 적용될 것으로 보인다.
테크인사이츠는 “2026년은 첨단 패키징 기술이 AI·HPC 시장을 넘어 모바일과 소비자 가전으로 확산되는 원년이 될 것”이라며, “향후 패키징 기술 경쟁, 설비 투자, 그리고 표준화 주도권 확보를 둘러싼 글로벌 경쟁이 본격화될 것”이라고 내다봤다.
